Pásztázó szondás módszerek
|
Eszköz: AIST-NT Smart SPM-1000
Kapcsolat: Kovács Zsolt (kovacs.zsolt@ttk.elte.hu) |
 |
Mérési lehetőségek:
-
Atomi erő mikroszkópia (AFM) kontakt, szemi-kontakt és nem kontakt módokban, laterális erő mikroszkópia és AFM vezető heggyel
-
Mágnese erő mikroszkópia (MFM)
-
Elektromos erő mikroszkópia (EFM), vagy konduktív AFM
-
Kelvin próba, felületi potenciál mikroszkópia (SPM)
-
Piezo-erő mikroszkópia (PRFM)
-
Pásztázó alagút mikorszkópia (STM)
-
Nanokeménység mérési lehetőség
-
Litográfia, mechanikus felület átalakítás

Specifikáció:
-
Automatikus kalibrációs mód, gyors szkennelési lehetőség pásztázott terület 100μm x 100μm, vertikális pásztázási tartomány 15μm.
-
Pásztázott terület optikai mikroszkópos keresése és motorizált asztalos beállítása 5mm x 5mm x 18mm tartományban
-
Aktív vibrációs kontroll asztal (TS-150)
-
1300 nm infravörös lézer az AFM esetében további Raman kompatibilitás miatt
A készülék motorizált x-y-z asztallal rendelkezik, hogy a minta felületén a vizsgálandó pozítciót kb. 5μm pontossággal optikai mikroszkópban megkereshessük és beállíthassuk. Ennél pontosabb lokalizálása a vizsgálandó területnek a minta pásztázását követően x-y piezo mozgatásának segítségével vitelezhető ki.
A berendezés sokféle felületvizsgálati módban használható. Általános felületi struktúra meghatározására használjuk a AFM szemi-kontakt módját. Analitikus felületi információ, illetve nagyobb lokalitás elérésére a nem-kontakt valamint a kontakt mód szolgál. Az AFM vizsgálatok alatt lehetőség nyílik a laterális erők mérésére, így felületi súrlódás, ill. közegellenállás felületi vizsgálatára.
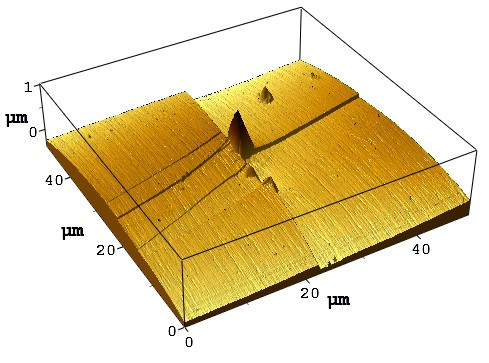
Néhány atom vastagságú csúszási sávok csavarással deformált tömbi fémüveg henger felületén
AFM vizsgálatok esetén, mágneses, illetve vezető bevonattal ellátott tű segítségével a felület mágneses (MFM), illetve elektromos (EFM) tulajdonságai képezhetők le a felületi struktúrák feltérképezését követően.
Vezető minták kilépési munkájának meghatározására szolgál a felületi potenciál mikroszkópia (SPM), vagy más néven a Kelvin próba.
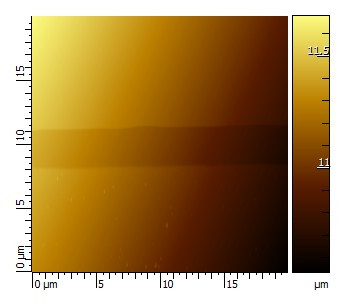 |
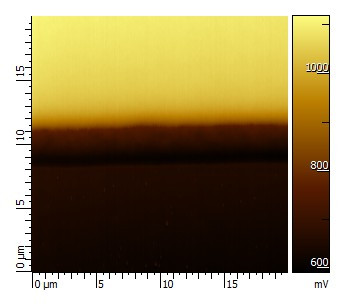 |
Felületi potenciál mikroszkópia Al-Au kalibrációs minta felületén. Balra a felület, jobbra kilépési munka eloszlása látható.
Nagy rugalmas állandójú AFM tű segítségével a felület rugalmas állandója határozható meg a tű alatti pontban, illetve külön felszerelhető nagy keménységű benyomófej (W hegy, vagy gyémánt piramis) a felületben képlékeny deformációt idéz elő és az AFM-mel vizsgált felületen nanoindentáció végezhető. A képlékeny nyomok a minta laterális mozgatása mellett litográfia jellegű felületmegmunkálást is lehetővé tesznek.
A berendezéshez rendelkezésre áll egy STM feltét, mellyel pásztázó tűs kísérletek végezhetők vezető mintákon. E módszer segítségével atomilag tiszta felületen elvileg lehetséges felületi atomok leképezése.
Az AFM laborban rendelkezésre áll a minták előkészítéshez és pásztázó hegy installálásához egy asztali sztereomikroszkóp, valamint részletes optikai vizsgálatokhoz egy Zeiss Imager Axio M2m optikai mikroszkóp.

